武田スーパー・クリーンルーム EB 描画機
武田スーパークリーンルーム
EB 描画機
東京大学大学院工学系研究科附属システム・デザイン研究センタ (d.lab、 ディーラボ)
(旧名 VDEC、大規模集積システム設計研究教育センタ)
学術支援専門職員
文部科学省ナノテクノロジー・プラットフォーム
微細加工プラットフォーム 実施機関 東京大学 支援員
藤原 誠
makoto@if.t.u-tokyo.ac.jp
https://www.if.t.u-tokyo.ac.jp/~makoto/project/revealjs/EB-Seminar/
武田先端知ビル
 http://www.vdec.u-tokyo.ac.jp/Guide/access.html
http://www.vdec.u-tokyo.ac.jp/Guide/access.html
Basement 2F Clean Room
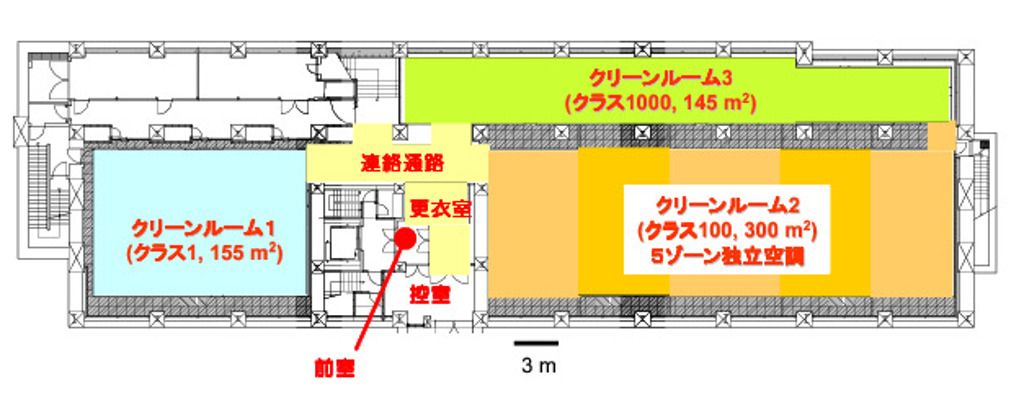
http://nanotechnet.t.u-tokyo.ac.jp/
| 区分 | 広さ (m2) | FED-STD Class |
|---|---|---|
| CR1 | 155 | Class 1 |
| CR2 | 60 | Class 1 |
| 240 | Class 100 | |
| CR3 | 145 | Class 1000 |
| Total | 600 | |
(地下二階) FED-STD -> ISO 14644-1
| 機種名 | foot print | 導入時期 |
|---|---|---|
| F5112 | 2.4 × 4.8 × 2.6 + 3.3 × 0.9 × 2.6 (m) | 2004 |
| F7000S | 3.5 × 4.8 × 2.55 (m) | 2013/12 |

Advantest F5112
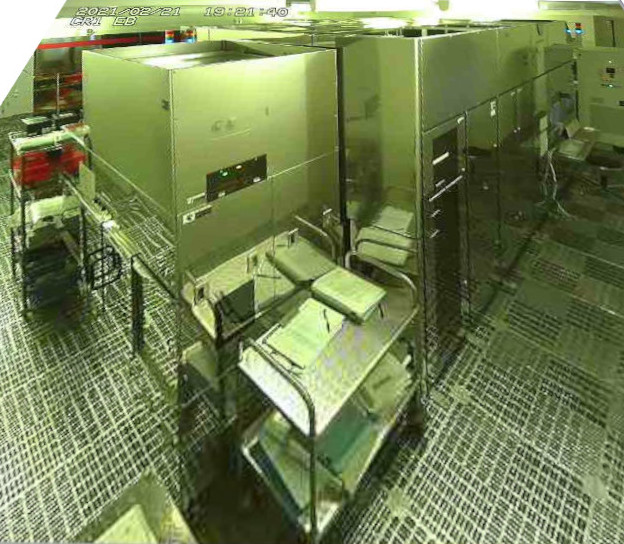
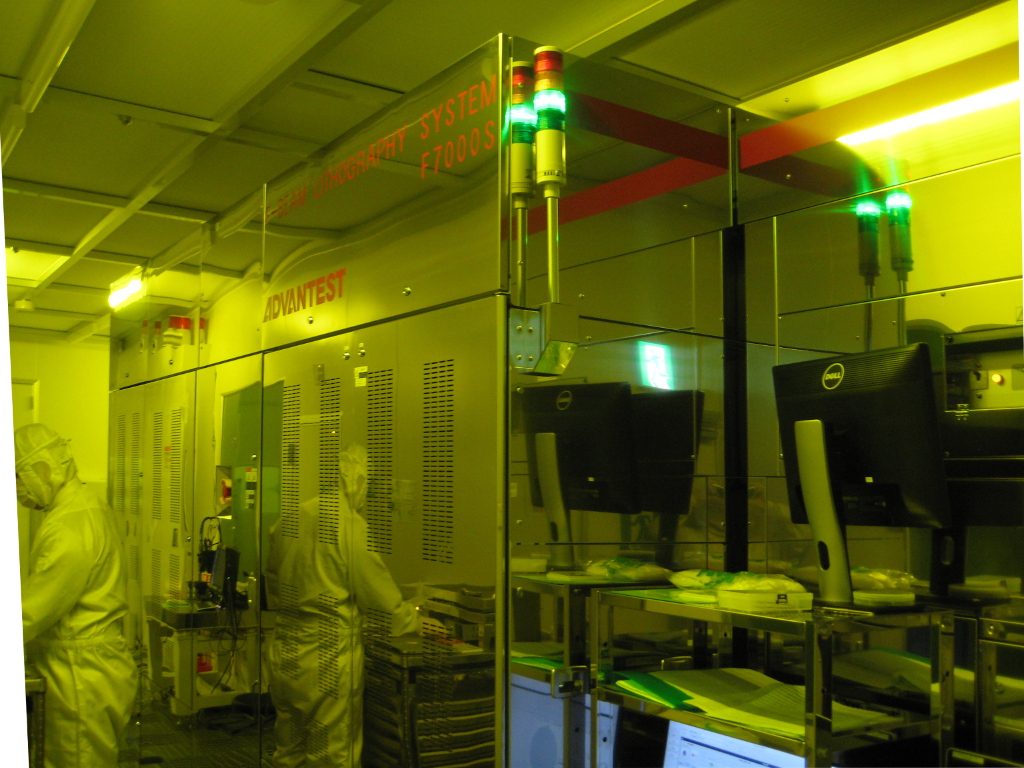

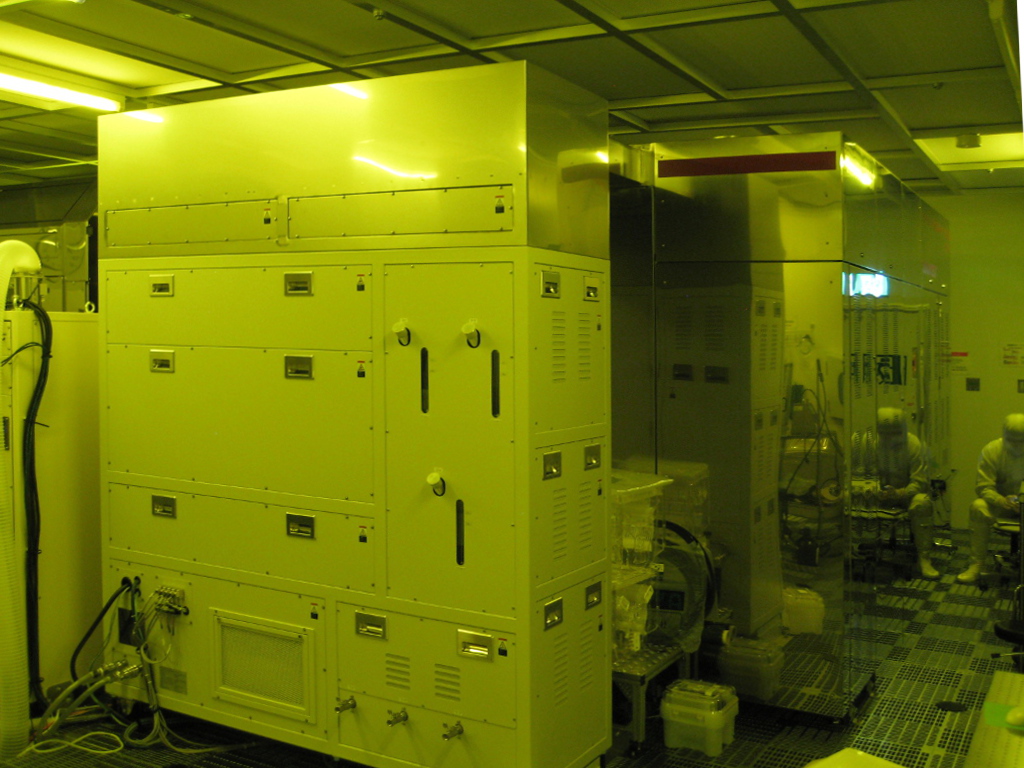
諸元 Specifications
| 機種 | 加速電圧 | 電流密度 | one shot の面積 | 電流 | 最大 DOSE | データ グリッド | 実力 | |
|---|---|---|---|---|---|---|---|---|
| 単位 | kV | A/cm2 | A/µm2 | µm2 | µA | µC/cm2 | nm | nm |
| F5112 | 50 | 20 | 0.2 | 16 | 3.2 | 120 | 2 | 100 |
| F7000S | 50 | 100 | 1 | 0.64 | 0.64 | 5000 | 0.25 | 1x |
| a | a × 10-8 | |||||||
| d | w | d × w | ||||||
二つの機種の速度の違いを決める要素の一つ
| one shot の大きさ | Field Size | |||
|---|---|---|---|---|
| F5112 | 4.0 x 4.0 | µm | 1600 x 800 | µm |
| F7000S | 0.8 x 0.8 | µm | 32 x 32 | µum |
Field size
Stage を動かさずに、 beam を振る範囲
基板の大きさ
| 機種 | mask | Wafer | 欠けチップ |
|---|---|---|---|
| F5112 | 5 inch | =< 6 inch | 10 m/m ~ 30 m/m 角 |
| F7000S | 5 inch | =< 8 inch | |
| 厚さ(共通) | 325/425/525 um | 625/675/725 um | |
描画の方式
| 方式 | 描画単位 | 描画単位の大きさ(最大) |
|---|---|---|
| point beam | 点 | |
| VSB | 可変長方形 | (0.8 um / 4 um 角) |
| CP | 装置内 stencil | (0.8 um 角の 25 %) |
| VSB | Variable Shape Beam |
| CP | Character Projection |
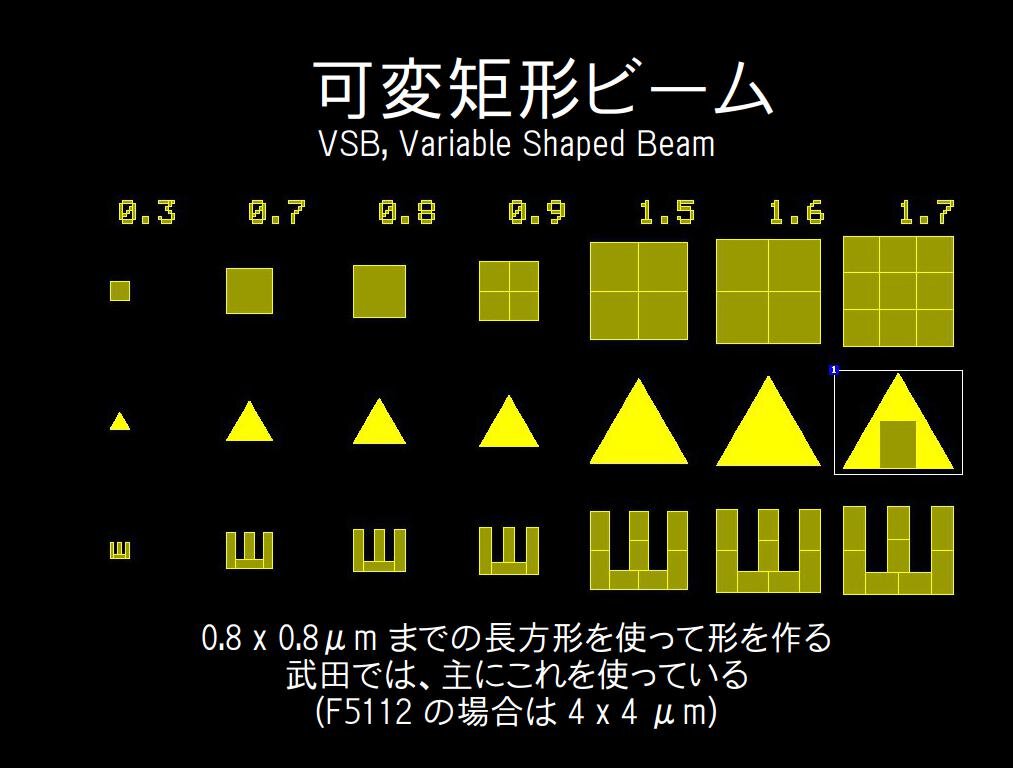

CP Stencil 7 x 7 (m/m) 25:1 scale

The number shown is CP Area #



Master Hole #3 ──────────────────────── 横可変線 14 - 120 nm幅 縦可変線 八角形 14 - 240nm 真円 10 - 90 nm 八角形 10 - 90 nm 12角形 10 - 90 nm Trimming #17 ──────────────────────── 真円 10 - 90 nm 八角形 10 - 90 nm 12角形 10 - 90 nm (その他) SIPH #18 ──────────────────────── 八角形 50 - 300nm 正三角形 300 nm 0-115 度 5 度 ピッチ 正方形 50 nm 0-85 度 5 度 ピッチ 正方形 100 nm 0-85 度 5 度 ピッチ
CP の使途 (sleeving)
100 nm の正方形で 40 角形 -> 1.25 um の円
sleeving 1.25 µm circle with 100 nm Sq (5 deg. step) [3] https://doi.org/10.1117/1.JMM.15.3.031606 [4] https://ieeexplore.ieee.org/abstract/document/8730981
CP の使途 (nano array)
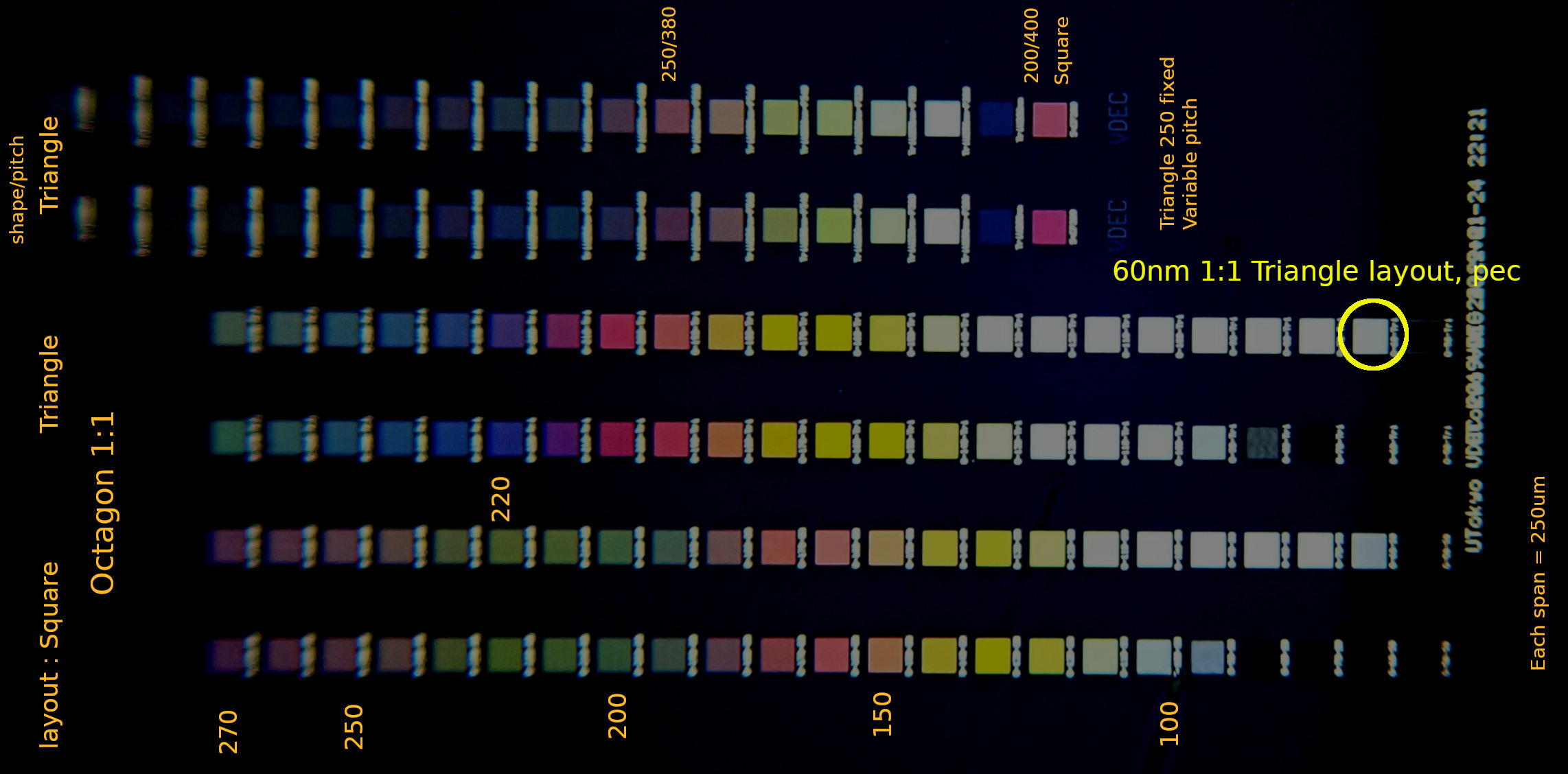
CP の使途 (nano array)

CP の使途 (nano_array)
CP の使途 (nano array)
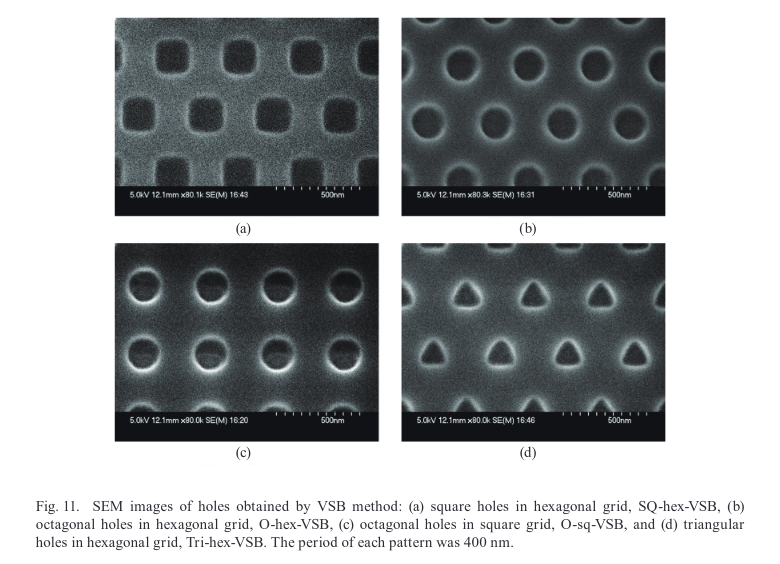
https://myukk.org/SM2017/sm_pdf/SM1952.pdf
CP の使途 (nano array)
60nm Hole, PEC あり、 SE+BSE(U) Regulus 8230
入力時の変換 F5112 bexelwin (Fujitsu/Advantest) pc-conv (内製) F7000S f7kcnv (dsjobput) (NCS/Advantest) BEAMER (GenIsys) 近接効果補正用データ (TRACER)
| 通称 | DOSE(µC/cm2) | 製品名 | 厚さ |
|---|---|---|---|
| Posi | |||
| CAP | 24 | OEBR-CAP112PM 21.5cP | 1.5 um |
| ZEP | 105 | ZEP-520A, ZEP-530 | 200-400 nm |
| FEP | 15 | FEP-171D | 250 nm |
| Nega | |||
| CAN | 24 | OEBR-CAN040AE 2.0cP | 120 nm |
| OEBR-CAN040AE 6.0cP | 690 nm | ||
| HSQ | 400 | XR-1541-06 (6%) | 200 - 250 nm |
| (2%) | 45 nm | ||
描画費用 1 chip/1 Wafer 一万円強、 90 分まで 90 分毎に同費用の追加料金 技術補助・技術代行 90分 (約) 3.5 万円
関連装置(その一)
-
スピンコータ
押鐘 SC-308 -
自動現像装置
ADE-3000S 3 inch -> 8 inch Wafer、 ZEP520A 専用 EVG-101 5 inch Mask 専用 -
マスク・エッチング
Spray Coater ACTIVE ACT-300AIIS
関連装置(その二)
Heidelberg DWL66+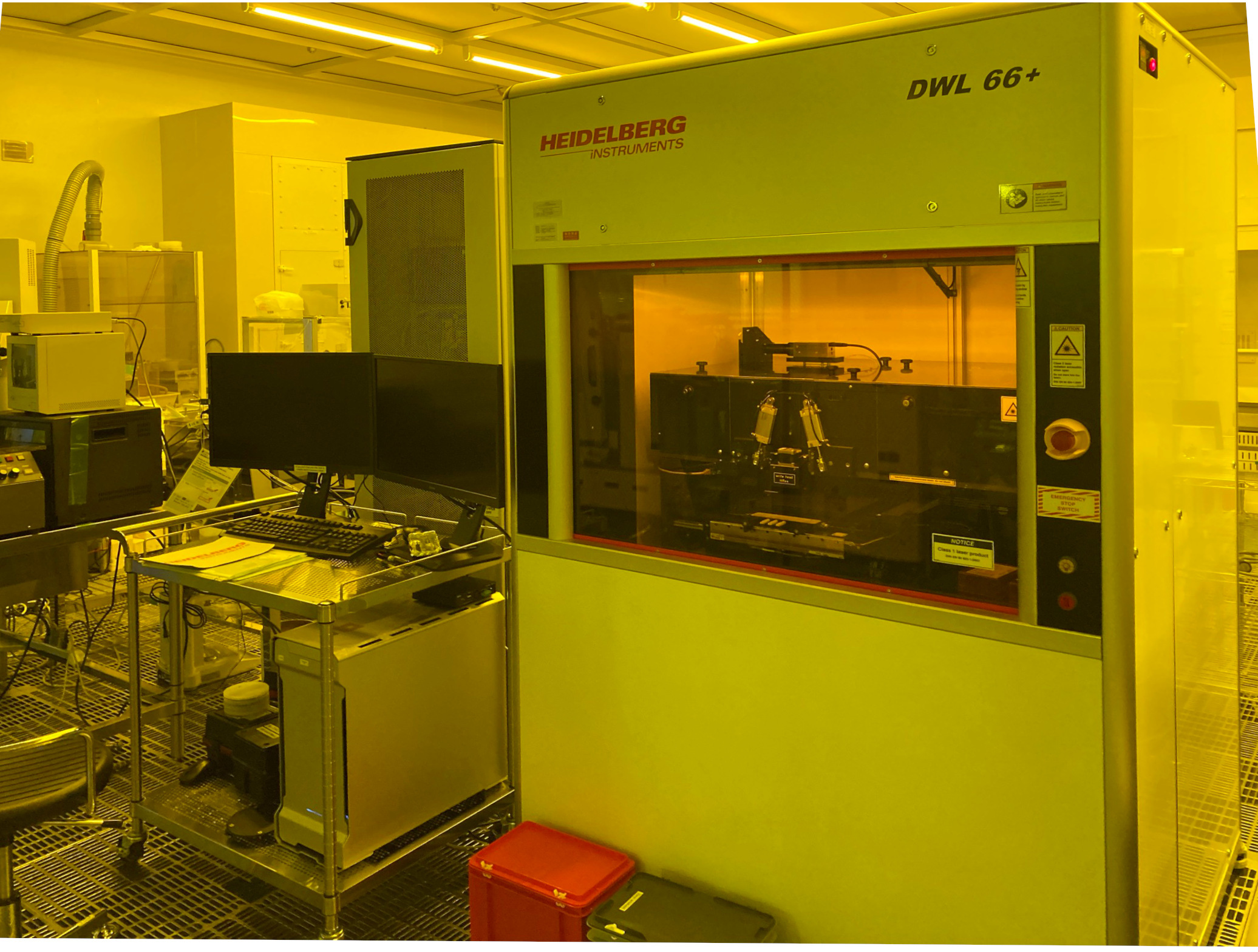
関連装置(その二)
Heidelberg DWL66+| Maximum exposure area: | 200 x 200 mm2 |
| Maximum substrate size: | 9" x 9" |
| Maximum substrate thickness: | 6mm |
| Camera system: | macro and micro 1280 x 960 pixels |

Reference
[1]
Hirofumi Hayakawa and Masahiro Takizawa, et. al,
Next generation electron beam lithography system F7000
for wide range applications
https://doi.org/10.1117/12.2029193
[2]
A.Higo, et.al
Experimental Comparison of Rapid Large-area Direct Electron
Beam Exposure Methods with Plasmonic Devices
https://myukk.org/SM2017/sm_pdf/SM1952.pdf
[3]
Rimon Ikeno, Satoshi Maruyama, Yoshio Mita, Makoto Ikeda, and
Kunihiro Asada "Electron-beam lithography with character projection
technique for high-throughput exposure with line-edge quality
control," Journal of Micro/Nanolithography, MEMS, and MOEMS 15(3),
031606 (8 September 2016). https://doi.org/10.1117/1.JMM.15.3.031606
[4]
Akio Higo, Tomoki Sawamura, Makoto Fujiwara, Etsuko Ota, Ayako
Mizushima, Eric Lebrasseur, Taro Arakawa, and Yoshio Mita,"A Micro
Racetrack Optical Resonator Test Structure to Optimize Pattern
Approximation in Direct Lithography Technologies," 2019 IEEE
Conference on Microelectronic Test Structures (ICMTS 2019),
Kita-Kyushu, Japan (2019.03)
URL
高速電子線描画装置を利用した 大面積微細描画支援
https://www.if.t.u-tokyo.ac.jp/~makoto/mgp/kunifes2016/
高速大面積電子線描画向け データ変換方法
https://www.if.t.u-tokyo.ac.jp/~makoto/mgp/kunifes2018/
Perl で GDSII を作成する
https://www.if.t.u-tokyo.ac.jp/~makoto/i/
This presentation material
https://www.if.t.u-tokyo.ac.jp/~makoto/project/revealjs/EB-Seminar/